現代產業的微小巨人:尖端 DFN 封裝如何推動電子發展

想像熙熙攘攘的工廠裡沒有大量、過時的機器,而是精簡、高效的機器:四處飛馳的機器人、監督每個流程的複雜感測器以及用於實時控制的無縫流動的數據。
為了應對關鍵工業環境帶來的挑戰,工程師積極尋求採用以其彈性和可靠性而聞名的半導體封裝中的積體電路 (IC)。這些封裝必須在嚴苛的條件下表現出卓越的
耐熱性和機械耐久性以及強大的電氣性能,從而確保最佳功能並延長系統壽命。
為了滿足現代工業的需求,半導體產業推出了用於 IC 的無引線表面貼裝元件 (SMD) 封裝,從而可以在電路中整合大量電子元件。隨著先進技術在更有限的空間
中實現更密集的電路,從而產生能夠在狹小空間內運行的時尚、輕便的機器,工業應用中笨重的電子產品的時代正在消失。隨著IC的發展和小型化,其相應的封
裝也發生轉變,變得越來越緊湊。這一趨勢延伸到了 ESD 保護裝置,例如瞬態電壓抑制(TVS) 二極體,用於保護工業應用的訊號介面和電源線。
在 PCB 組裝領域,眾多表面貼裝 IC 封裝在增強電子設備的功能方面發揮關鍵作用。其中 DFN(雙扁平無引線)封裝值得注意,其特點是尺寸緊湊且具有令人印
象深刻的多功能性。在本部落格中,我們將探討利用 DFN 封裝的優勢及其在 TVS 二極體中的應用,以實現工業應用的 ESD 保護。
半導體封裝組裝背景
半導體封裝組裝的魔力在於科學、工程和藝術的交叉。它關乎效率、可靠性和經濟性,將微型晶片轉變為為我們的世界(從智慧型手機到太空船)提供動力的主力。
半導體封裝組裝不只是封裝矽晶片;它涉及營造一個微環境,使微型矽晶片能夠生存並發揮最大潛力。標準半導體封裝的設計旨在為晶片提供電力並促進矽晶片之間
的訊號分配。此外,它還能散發 IC 產生的熱量,使其保持在允許的溫度範圍內。不僅如此,封裝還可以保護晶片免受各種因素的影響,包括潮濕、電磁輻射、溫度波動
和機械振動。封裝組裝技術大致可分為兩大類:引線鍵結和倒裝晶片技術。
在圖 1 所示的引線鍵結半導體封裝組件中,矽晶片固定在基板上,其有源面朝上。隨後,由金、鋁或銅等材料組成的精緻導線從矽晶片上的焊盤連接到封裝上相應
的金屬引線或焊盤。
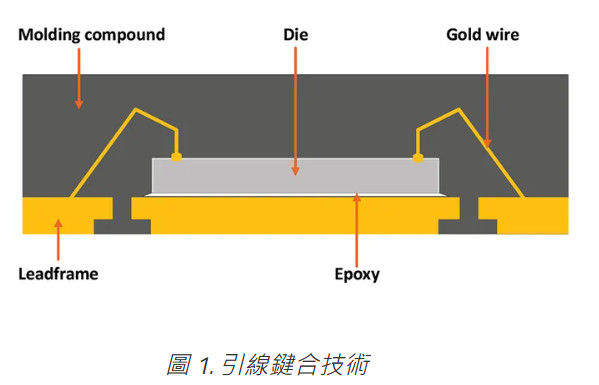
在倒裝晶片封裝的組裝過程中,焊錫凸塊取代焊線將IC連接到基板。此方法涉及在晶片焊盤上沉積微小的焊料凸點,作為晶片和基板之間的互連點。隨後,
將晶片倒置,將其主動側定位,使焊料凸塊朝下。倒裝晶片技術如圖 2 所示。倒裝晶片技術擅長在更小的區域內以更短的互連長度創建密集的互連。
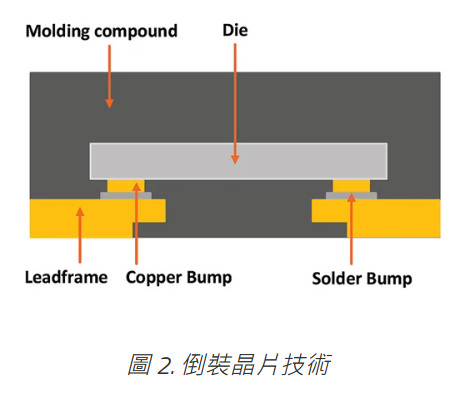
在 ESD 保護元件中,半導體封裝發揮著尤為重要的作用。例如,TVS 二極體透過將突波從其所保護的組件上轉移出去,在使電子電路承受 ESD 事件方面發揮著
至關重要的作用。由於此類事件期間的靜電尖峰可達數萬伏,對現代系統中的精密電子設備構成威脅,因此要主動避免組裝成品中因此類現象而可能出現的故障
,需要採用強有力的保護措施。
為什麼在工業應用中使用無引線 DFN 封裝?
當工程師設計工業應用時,他們喜歡堅固可靠的封裝,能夠承受具有挑戰性的環境和極端的電氣條件。直到最近,工業應用中的普遍選擇涉及使用引線 IC 封裝。
選擇引線封裝的理由是它們易於安裝在 PCB 上。這些引線有助於對 PCB 進行快速目視檢查,從而能夠檢測和排除損壞的連接。此外,引線封裝具有成本效益並且
具有良好的散熱特性。然而,許多引線封裝具有顯著的寄生效應,限制了它們在各種應用中的表現。此外,由於尺寸的原因,這些引線 SMD 封裝佔據了 PCB 的
很大一部分。
多年來,無引線DFN 封裝在工業應用中越來越受歡迎,主要是因為以下優點:
-
尺寸緊湊,節省空間
DFN 封裝的特點是沒有延長引線;它們的接觸點位於組件下方而不是沿著其周邊,從而形成更緊湊的外形。因此,與引線 SMD 封裝相比,這些封裝可顯著節省空間。
例如,考慮尺寸約為 2.9mm x 1.6mm 的引線 SOT23 封裝,佔地 4.64mm²。相比之下,DFN 1006 封裝的尺寸約為 1.0mm x 0.6mm,佔地面積約為 0.6mm²。
這相當於 PCB 空間顯著減少 87%。這兩種封裝尺寸的比較如圖 3 所示。

-
出色的熱性能
無引線 DFN 封裝卓越的散熱能力或熱性能使其成為工業應用的首選。其巧妙的設計在底部採用了外露散熱墊,與 PCB 無縫粘合。它充當 IC 的整合式散熱器,
為熱量散發到 PCB 上建立直接路徑,從而無需額外的笨重散熱器。這種設計可實現更緊湊的封裝,並有利於縮短散熱路徑。此外,與傳統的引線封裝相比,更
大的接觸面積確保了卓越的熱效率,使 DFN 成為精確溫度控制至關重要的工業應用的最佳選擇。
-
更好的電氣屬性
與含鉛 SMD 封裝相比,DFN 封裝具有較低的寄生電感和電容。帶引線 SMD 封裝中這些寄生元件的存在可能會限制頻率響應或損害其他彈性電路設計的訊號
完整性。相較之下,DFN 封裝在訊號完整性效能方面表現出色,這使得它們對於高速應用特別有吸引力。
-
機械強度
無引線 DFN 封裝的另一個優點是其堅固度。 DFN 封裝在封裝底部設計有較大的接觸面積,並直接焊接到 PCB 上。圖 3 顯示了 SOT-23 和 DFN 1006 封裝的
接觸面積與封裝的比率。這確保了 DFN 1006 封裝與 PCB 之間的可靠接觸,其中封裝的大部分都黏合在 PCB 上。
挑戰與解決方案:Semtech 具有側面可潤濕側翼的 DFN 封裝
無引線 DFN 封裝面臨的挑戰在於封裝後組裝過程中 PCB 上焊點的可視性有限,因為這些連接隱藏在封裝下方,從頂部和側面都看不到。因此,確認 IC 與 PCB
正確接合變得不確定。為了應對這項挑戰,Semtech 推出了採用 DFN 封裝的 TVS 二極體,該二極體採用稱為側面可濕性側面的解決方案。
側面可潤濕側面採用一種技術來確保焊料從 IC 底部擴散,沿著牆壁的側面向上流動,並形成可見的焊料圓角。此功能可目視檢查引線垂直側和 PCB 焊盤之間形成
的「凸塊」。因此,自動目視檢查 (AVI) 系統可以確認每個電氣接頭是否足夠,驗證 IC 與 PCB 的正確接合併確保連接可靠(圖 4)。 AVI 在檢查電子元件、組件
或 PCB 的視覺外觀以識別製造過程中的缺陷、錯誤或異常方面發揮著至關重要的作用。
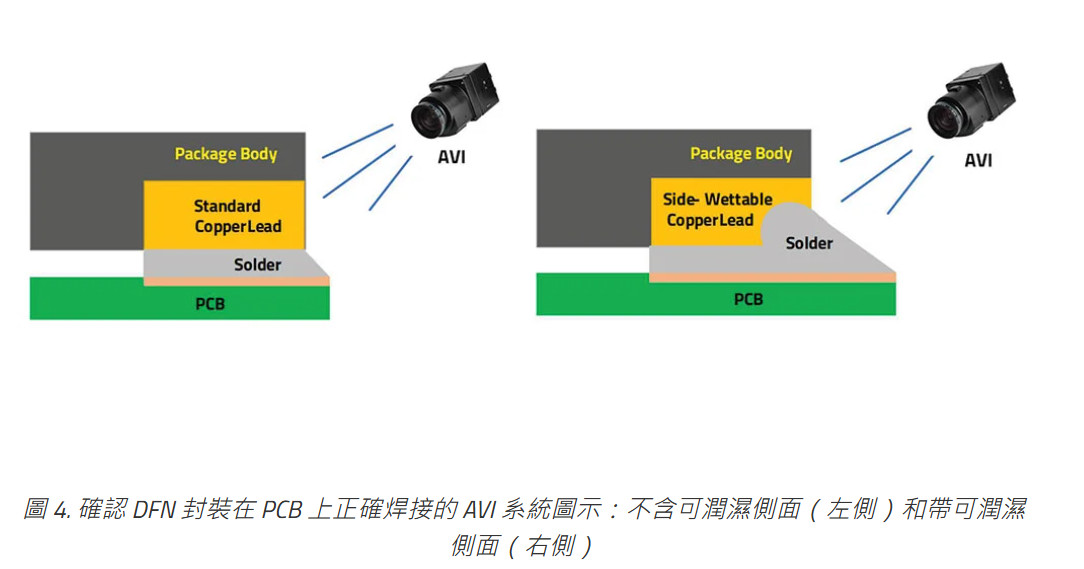
側面可潤濕的側翼具有幾個額外的優點。它們增強了可靠性並隨後提高了產量。 Semtech 的側面可潤濕側翼技術(如圖 5 所示)在 IC 和 PCB 之間建立了牢固的連接,
即使在受到振動或晃動的應用中也能防止 IC 分離。同時,該技術有助於節省成本和時間。鍍錫用於覆蓋銅端子作為保護層,防止銅隨著時間的推移而氧化。

Semtech 的 TVS 二極體具有側面可潤濕側面
Semtech 推出了一系列單線 TVS 二極體,如表 1 所示,採用 0402 尺寸 (1.0mm x 0.6 mm x 0.55mm) DFN 格式封裝,採用倒裝晶片技術,並具有專為非-汽車工業應用。
這些 TVS 二極體具有多種功能,可為高速訊號線、CC/SBU 線、VBus 線和 D+/D- 線上的 Thunderbolt 3、USB 3.0/3.2、USB Type-C 連接器提供 ESD 保護。此外,它們
還適用於防止 RF 和 FM 天線、觸控螢幕控制器、12V DC 線路、側鍵/小鍵盤、音訊連接埠、物聯網設備、便攜式儀器、通用輸入輸出 (GPIO) 線路等中的 ESD 保護,當然是工業設備。

表 1:採用 DFN 封裝的各種 Semtech 零件,用於保護工業應用
結論
Semtech 是 TVS 二極體的著名製造商,其產品採用採用側面可潤濕側翼的 DFN 封裝。採用側面可潤濕側翼技術的 DFN 封裝可節省電路板空間,並為自動視覺檢測 (AVI)
提供出色的焊點可視性,從而提高可靠性和產量。此外,採用倒裝晶片技術的 DFN 封裝還提供卓越的熱管理能力和更高的功率密度。現今的智慧工業應用需要採用具有
側面可潤濕側面的 DFN 封裝的 TVS 二極體,以充分保護電源線、通訊匯流排和介面。
- 我要聯絡 : (台灣)semtech.tw@aitgroup.com.tw
- 我要聯絡 : (中國)semtech.cn@aitgroup.com.tw
- 我要聯絡 : (新加坡)semtech.tw@aitgroup.com.tw
- 我要聯絡 : (馬來西亞)semtech.tw@aitgroup.com.tw
- 我要聯絡 : (泰國)semtech.tw@aitgroup.com.tw
- 我要聯絡 : (菲律賓)semtech.tw@aitgroup.com.tw
- 我要聯絡 : (越南)semtech.tw@aitgroup.com.tw
- 我要聯絡 : (印尼)semtech.tw@aitgroup.com.tw